QR kodea

Guri buruz
Produktuak
Jarri gurekin harremanetan

Mugikorra

Faxa
+86-579-87223657

Posta elektronikoa

Helbidea
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Probintzia, Txina
Silizio epitaxiaoinarrizko prozesu erabakigarria da erdieroaleen fabrikazio modernoan. Kristal bakarreko siliziozko film meheen geruza bat edo gehiago hazteko prozesuari egiten dio erreferentzia, kristal bakarreko egitura, lodiera, doping-kontzentrazioa eta mota zehatz leundutako siliziozko substratu batean. Hazitako film honi geruza epitaxiala deitzen zaio (Epitaxial Layer edo Epi Layer), eta geruza epitaxiala duen siliziozko obleari silizio epitaxiala deitzen zaio. Bere oinarrizko ezaugarria da hazi berria den silizio epitaxial geruza kristalografian substratu-sarearen egituraren jarraipena dela, substratuaren orientazio kristal berdina mantenduz, kristal bakarreko egitura perfektua osatuz. Horri esker, geruza epitaxialak substratuaren desberdinak diren propietate elektrikoak zehatz diseinatzen ditu, eta, hortaz, errendimendu handiko gailu erdieroaleak fabrikatzeko oinarria eskaintzen du.
![]()
Silizio Epitaxirako susceptor epitaxial bertikala
1) Definizioa: Silizio epitaxia silizio-atomoak kristal bakarreko silizio-substratu batean metatzen dituen teknologia da, metodo kimiko edo fisikoen bidez eta substratu-sarearen egituraren arabera antolatzen dituen kristal bakarreko siliziozko film mehe berri bat hazteko.
2) Sare bat etortzea: Ezaugarri nagusia hazkunde epitaxialaren ordenatasuna da. Jarritako silizio-atomoak ez dira ausaz pilatzen, baizik eta substratuaren kristal-orientazioaren arabera antolatzen dira atomoek substratuaren gainazalean emandako "txantiloiaren" gidaritzapean, atomo-mailako erreplikazio zehatza lortuz. Horrek bermatzen du geruza epitaxiala kalitate handiko kristal bakarrekoa dela, polikristalinoa edo amorfoa izan beharrean.
3) Kontrolagarritasuna: Siliziozko epitaxia prozesuak hazkuntza-geruzaren lodiera (nanometroetatik mikrometroetara), dopin mota (N mota edo P mota) eta dopin-kontzentrazioa kontrolatzeko aukera ematen du. Horri esker, propietate elektriko desberdinak dituzten eskualdeak eratu daitezke siliziozko oblea berean, hori baita zirkuitu integratu konplexuak fabrikatzeko gakoa.
4) Interfazearen ezaugarriak: Geruza epitaxialaren eta substratuaren artean interfaze bat sortzen da. Egokiena, interfaze hau atomikoki laua eta kutsadurarik gabekoa da. Hala ere, interfazearen kalitatea funtsezkoa da geruza epitaxialaren errendimendurako, eta edozein akats edo kutsadurak gailuaren azken errendimenduan eragina izan dezake.
Silizioaren hazkunde epitaxiala, batez ere, silizio atomoek substratuaren gainazalean migratzeko eta konbinaziorako energia-sarearen posiziorik baxuena aurkitzeko energia eta ingurune egokia eskaintzearen araberakoa da. Gaur egun gehien erabiltzen den teknologia lurrun kimikoa (CVD) da.
Lurrun Kimikoaren Deposizioa (CVD): silizio epitaxia lortzeko metodo nagusia da. Bere oinarrizko printzipioak hauek dira:
● Aurrekarien garraioa: Silizio-elementua (aurrekaria) duen gasa, hala nola silanoa (SiH4), diklorosilanoa (SiH2Cl2) edo triklorosilanoa (SiHCl3), eta gas dopatzailea (adibidez, fosfina PH3 N motako dopinerako eta diborano B2H6 P motako dopatzeko) proportzio zehatzetan nahasten dira eta erreakzio-ganberara pasatzen dira.
● Azaleko erreakzioa: Tenperatura altuetan (normalean 900°C eta 1200°C artean), gas hauek deskonposizio kimikoa edo erreakzioa jasaten dute berotutako silizio-substratuaren gainazalean. Adibidez, SiH4→Si(solidoa)+2H2(gasa).
● Gainazaleko migrazioa eta nukleazioa: Deskonposizioak sortutako silizio-atomoak substratuaren gainazalean xurgatzen dira eta gainazalean migratzen dira, azkenean sare-gune egokia aurkitzen dute konbinatzeko eta bakar berri bat osatzen hasteko.kristal geruza. Hazkunde epitaxialaren silizioaren kalitatea urrats honen kontrolaren araberakoa da neurri handi batean.
● Geruzadun hazkundea: Jarri berri den geruza atomikoak etengabe errepikatzen du substratuaren sare-egitura, geruzaz geruza hazten da eta lodiera zehatz batekin silizio epitaxial geruza bat eratzen du.
Prozesuaren funtsezko parametroak: silizio epitaxiaren prozesuaren kalitatea zorrotz kontrolatzen da, eta funtsezko parametroak hauek dira:
● Tenperatura: erreakzio-abiadurari, gainazaleko mugikortasunari eta akatsen eraketari eragiten dio.
● Presioa: gasaren garraioan eta erreakzio-bidean eragiten du.
● Gas emaria eta ratioa: hazkunde-tasa eta dopin-kontzentrazioa zehazten ditu.
● Substratuaren gainazalaren garbitasuna: Edozein kutsatzaile izan daiteke akatsen jatorria.
● Beste teknologia batzuk: CVD nagusia den arren, Molecular Beam Epitaxy (MBE) bezalako teknologiak silizio epitaxiarako ere erabil daitezke, batez ere I+G edo oso doitasun handiko kontrola behar duten aplikazio berezietan.MBE-k silizio iturriak zuzenean lurruntzen ditu huts oso handiko ingurune batean, eta hazte atomikoak edo molekularrak substratuan zuzenean proiektatzen dira hazteko.
Silizio epitaxia teknologiak siliziozko materialen aplikazio sorta asko zabaldu du eta gailu erdieroale aurreratu askoren fabrikazioan ezinbestekoa da.
● CMOS teknologia: Errendimendu handiko txip logikoetan (adibidez, CPUetan eta GPUetan), dopatu baxuko (P− edo N−) silizio epitaxial geruza bat hazten da sarritan dopatutako (P+ edo N+) substratu handi batean. Silizio epitaxial obleen egitura honek latch-up efektua (Latch-up) eraginkortasunez kendu dezake, gailuaren fidagarritasuna hobetu eta substratuaren erresistentzia baxua mantentzen du, korrontearen eroapena eta beroa xahutzeko lagungarria dena.
● Transistore bipolarrak (BJT) eta BiCMOS: Gailu hauetan, silizio epitaxia erabiltzen da oinarria edo kolektore-eskualdea bezalako egiturak zehaztasunez eraikitzeko, eta transistorearen irabazia, abiadura eta beste ezaugarri batzuk optimizatzen dira geruza epitaxialaren dopin-kontzentrazioa eta lodiera kontrolatuz.
● Irudi-sentsorea (CIS): Irudi sentsoreen aplikazio batzuetan, silizio epitaxialek pixelen isolamendu elektrikoa hobetu dezakete, diafonia murriztu eta bihurtze fotoelektrikoaren eraginkortasuna optimiza dezakete. Geruza epitaxialak eremu aktibo garbiagoa eta akastunagoa eskaintzen du.
● Prozesu-nodo aurreratuak: Gailuaren tamaina murrizten doan heinean, materialaren propietateen baldintzak gero eta handiagoak dira. Silizio epitaxia teknologia, hazkunde epitaxial selektiboa (SEG) barne, silizio edo silizio germanio (SiGe) epitaxia geruza tentsioak hazteko erabiltzen da eremu zehatzetan, garraiolarien mugikortasuna hobetzeko eta, horrela, transistoreen abiadura handitzeko.
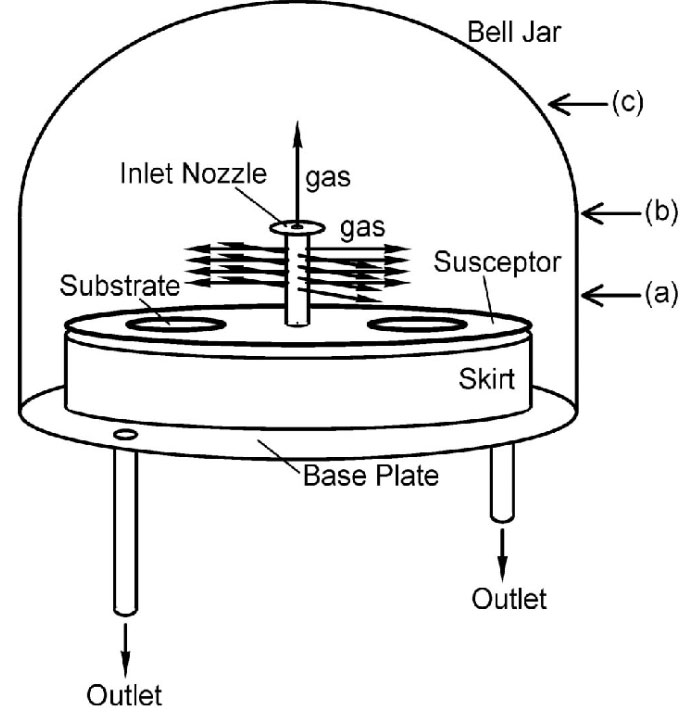
Silizio Epitaxirako Susceptor Epitaxial Horizontala
Silizio epitaxiaren teknologia heldua eta oso erabilia den arren, oraindik ere erronka eta arazo batzuk daude silizioaren prozesu epitaxialean:
● Akatsen kontrola: Hazkunde epitaxialean hainbat kristal-akatsak sor daitezke, hala nola pilaketa akatsak, dislokazioak, irristatze-lerroak, etab. Akats hauek gailuaren errendimendu elektrikoari, fidagarritasunari eta errendimenduari larriki eragin diezaiokete. Akatsak kontrolatzeko ingurune oso garbia, prozesu-parametro optimizatuak eta kalitate handiko substratuak behar dira.
● Uniformetasuna: Geruza epitaxialaren lodieraren uniformetasun perfektua eta tamaina handiko silizio-obletan (300 mm-ko adibidez) dopinaren kontzentrazioa lortzea etengabeko erronka da. Uniformetasunik ezak gailuaren errendimenduan desberdintasunak sor ditzake oble berean.
● Autodopina: Hazkuntza epitaxialaren prozesuan zehar, substratuan kontzentrazio handiko dopatzaileak hazten ari den geruza epitaxialean sar daitezke gas-fasearen difusioaren edo egoera solidoaren difusioaren bidez, epitaxiaren geruza dopinaren kontzentrazioa espero den baliotik aldentzea eraginez, batez ere geruza epitaxialaren eta substratuaren arteko interfazetik gertu. Hau da silizio epitaxia prozesuan landu beharreko gaietako bat.
● Azaleko morfologia: Geruza epitaxialaren gainazala oso laua izan behar da, eta zimurtasun edo gainazaleko akatsek (lainoa adibidez) ondorengo prozesuetan eragina izango dute, hala nola litografia.
● Kostua: Leundutako siliziozko obleekin alderatuta, silizio epitaxial obleen ekoizpenak prozesuko urrats gehigarriak eta ekipamenduen inbertsioa gehitzen ditu, kostu handiagoak eraginez.
● Epitaxia selektiboaren erronkak: Prozesu aurreratuetan, hazkuntza epitaxial selektiboak (hazkundea eremu zehatzetan soilik) eskakizun handiagoak ezartzen dizkio prozesuaren kontrolari, hala nola, hazkunde-tasa selektibitatea, albo-hazkundearen kontrola, etab.
Erdieroaleen materiala prestatzeko teknologia gako gisa, oinarrizko ezaugarriasilizio epitaxiaKristal bakarreko silizio epitaxial geruzak zehaztasunez hazteko gaitasuna da, propietate elektriko eta fisiko espezifikoak dituzten kristal bakarreko siliziozko substratuetan. Silizio epitaxia prozesuan tenperatura, presioa eta aire-fluxua bezalako parametroen kontrol zehatzaren bidez, geruzen lodiera eta dopinaren banaketa pertsonaliza daitezke erdieroaleen hainbat aplikazioren beharrak asetzeko, hala nola CMOS, potentzia-gailu eta sentsoreak.
Silizioaren hazkunde epitaxialak akatsen kontrola, uniformetasuna, autodopina eta kostua bezalako erronkak baditu ere, teknologiaren etengabeko aurrerapenarekin, silizio epitaxia gailu erdieroaleen errendimenduaren hobekuntza eta berrikuntza funtzionala sustatzeko indar nagusietako bat da oraindik, eta silizio epitaxialeko obleen fabrikazioan duen posizioa ordezkaezina da.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Probintzia, Txina
Copyright © 2024 VeTek Semiconductor Technology Co., Ltd. Eskubide guztiak erreserbatuta.
Links | Sitemap | RSS | XML | Privacy Policy |
